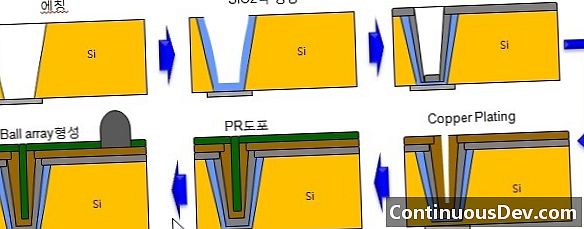
Obsah
- Definícia - Čo znamená „Via-Silicon Via“ (TSV)?
- Úvod do programu Microsoft Azure a Microsoft Cloud V tejto príručke sa dozviete, o čom všetko je cloud computing a ako vám môže Microsoft Azure pomôcť migrovať a podnikať z cloudu.
- Techopedia vysvetľuje systém Via-Silicon Via (TSV)
Definícia - Čo znamená „Via-Silicon Via“ (TSV)?
Priebežný kremík cez (TSV) je typ spoja (vertikálny prepojovací prístup), ktorý sa používa v technike a výrobe mikročipov a ktorý úplne prechádza kremíkovou matricou alebo oblátkou, aby sa umožnilo stohovanie kremíkových kociek. TSV je dôležitým komponentom pre vytváranie 3-D balíkov a 3-D integrovaných obvodov. Tento typ pripojenia funguje lepšie ako jeho alternatívy, napríklad balík na balíku, pretože jeho hustota je vyššia a jeho pripojenia kratšie.Úvod do programu Microsoft Azure a Microsoft Cloud V tejto príručke sa dozviete, o čom všetko je cloud computing a ako vám môže Microsoft Azure pomôcť migrovať a podnikať z cloudu.
Techopedia vysvetľuje systém Via-Silicon Via (TSV)
Prostredníctvom kremíka cez (TSV) sa používa na vytváranie trojrozmerných balíkov, ktoré obsahujú viac ako jeden integrovaný obvod (IC), ktorý je vertikálne stohovaný takým spôsobom, ktorý zaberá menej miesta a zároveň umožňuje väčšiu konektivitu. Pred TSV mali trojrozmerné balíčky naskladané integrované obvody obvodov na okrajoch, čo zväčšovalo dĺžku a šírku a zvyčajne si vyžadovalo ďalšiu vrstvu „vkladača“ medzi IC, čo viedlo k oveľa väčšiemu obalu. TSV odstraňuje potrebu zapojenia okrajov a vkladačov, čo vedie k menšiemu a ploššiemu baleniu.Trojrozmerné integrované obvody sú vertikálne naskladané čipy podobné baleniu 3D, ale pôsobia ako jedna jednotka, čo im umožňuje zabaliť viac funkcií do relatívne malej pätky. TSV to ďalej zvyšuje poskytovaním krátkeho vysokorýchlostného spojenia medzi rôznymi vrstvami.